|
<解説記事ダウンロード>
<概要>
シリコン単結晶に中性子を照射すると、シリコン中に存在する30Siが中性子照射を受け31Siが生成され、これがベータ(β)崩壊して安定同位元素31Pに変換する。中性子(照射)ドーピングは、この反応を利用してシリコン中にリンを均一にドープする方法である。この方法は、シリコン単結晶中のリンの分布が従来の不純物元素を添加する方法では得られない均一性を示すとともに、中性子照射時間を制御することにより添加するリンの濃度を精度良く決めることができる。 通常、この製造法をNTD(Neutron Transmutation Doping)法と称し、この方法で製造された半導体用シリコンを通称NTDシリコン(Neutron Transmutation Doped Solicon)と呼ぶ。NTD法はリンの添加方法であるので、n型半導体用シリコン単結晶の製造に利用される。 <更新年月> 2006年11月 (本データは原則として更新対象外とします。)
<本文>
1.製造原理 シリコンに中性子を照射すると、シリコン(同位体元素構成:28Si、29Siおよび30Si)中の30Si(天然存在比:3.05%)が中性子の照射を受け、31Si(半減期:2.62時間)が生成される。31Siはベータ線(β崩壊)を出し、核変換し、安定同位元素のリン(31P)に変換する。 シリコン中性子照射ドーピングは、この現象を利用し、シリコン単結晶を中性子で照射し、単結晶中にリン(31P)を均一にドープ(添加)させる方法である。シリコン単結晶中のリンの分布が、従来の不純物元素を添加する方法では得られない均一性を示すため、半導体製造の一分野を成している。 [n+30Si] → 31Si → [31P+β] 中性子照射の前のシリコンは絶縁物に近いほど導電性が低いが、中性子照射によってごく少量のリンが生成すると、その量に応じて導電性が上がりn型のシリコン半導体となる。 2.開発経緯 シリコン単結晶に中性子を照射しリン(P)を均一にドープするNTD法は1961年にベルテレフォン研究炉のTanenbaumらにより発表され、その後、半導体の進歩とともに1975年頃より実用化されていった。 実用規模の照射は、1974年デンマークのリゼ(リソ)研究所の研究炉を利用したものが最初である。その後、品質の優秀性と半導体需要の増大に対応し、多数の原子炉に照射装置が設置され、現在でも世界中の研究炉を利用して大量に生産されている。 在来法では、通常、シリコン単結晶の製造工程において、半導体特性を生成させる不純物元素をガス状で直接シリコン融液部に吹き付ける等の方法で、シリコン半導体素材を製造していた。しかし、その成長機構によって単結晶化の際に結晶中に均一に取り込まれにくく、不純物元素の含有量はばらつきが生じ易かった。一方、30Siは、シリコン単結晶中に均一に存在しているため、原理的には中性子を吸収して生成されるリンは均一に分布する。半導体素子の製造にあたって抵抗率の変動は特性に影響するため、特に、大口径の結晶については、31Pの均一性すなわち抵抗率分布の均一性は重要な要素である。一般には、6インチ口径のシリコン単結晶において、在来法の±20%に対し、NTD法で±5%の均一度が得られると言われている。 このように、NTDシリコンは抵抗率の均一性に優れていることから、電力用サイリスタ(シリコン制御整流器)として使用されるようになり、半導体パワーデバイスとして一般産業分野から家電分野まで広く利用されている。また、中性子照射量と抵抗率の変化が明確であるため、希望する抵抗値の単結晶を作り易く、精度の高い半導体素材を得ることができる。さらに、大電力素子では、大口径に加えて、高比抵抗領域での均一性が要求されるため、NTDシリコンの必要性が大きくなっている。半導体直径も増大の一歩をたどっており、現在は5、6インチが主流となっている。 NTDシリコンの製造工程説明図を 図1に示す。長尺円柱状の単結晶シリコンインゴットは、照射装置を用いて原子炉内に挿入される。原子炉内で照射するシリコンインゴットは、多くの場合、取扱重量の理由から長さ約20cmまたは約30cm(6インチ径で重量約11kg相当)のブロックに短尺化されたものが用いられ、炉心の高さ方向の中性子束分布の勾配に合わせ、これら短尺ブロックを数段重ねて照射孔に挿入される。中性子照射を終えたシリコンインゴットはスライスマシンによって厚さ1mm以下に切断され、ウエハー製品となって市場に出される。 照射上の留意点としては、 ・照射後の目標とする抵抗率は、中性子の照射量によって定まる。目標抵抗率の精度を高めるためには、ある程度中性子照射量を大きくし変動誤差を少なくする必要がある。従って、照射にあたって照射前後の抵抗率に十分大きな差ができるように素材を選択することが重要である。 ・照射損傷の観点からは、熱中性子成分の多い場所での照射が望ましい。 ・インゴット内の面内抵抗率分布の均一性:照射時にシリコンインゴットの軸を中心に定速回転させることにより面内の均一な照射を可能とする。 ・インゴット内の軸方向抵抗率分布の均一性:フィルター法(中性子束の空間分布に対応した中性子吸収体を置き、全長にわたり中性子束分布を均一にする)、反転法(中性子束分布を考慮し、照射の中間でシリコン試料を反転させ、逆補正を行う)、定速移動法(試料をヘリカルに回転させながら、一定速度で一方向に通過させながら照射する。中性子束の時間変化がなければ、原理的に完全に均一となる)等による。国内炉では反転法が採用されている。 ・照射量の制御:目標とする抵抗率を精度良く得るため自己出力型中性子検出器(SPND)等による照射量のモニターを行う。さらに省力化のためコンピュータと連動した自動制御システムの導入もある。 3.シリコン単結晶製造とNTDシリコン結晶の製造 照射原料となるシリコンの単結晶は以下のような方法で製造されている。 (1)CZシリコン単結晶(抵抗率:0.001〜50 Ω・cm) シリコン多結晶の塊を石英るつぼで加熱溶融し、種結晶を漬けてゆっくり回転させながら引き上げる引き上げ法(CZ法:Czochralski Method)により作られる単結晶である。本法を最初に試みたチョクラルスキー(Czochralski)氏にちなんでCZ法と称される。所定の抵抗値になるように一定量の不純物元素を添加するが、結晶中の不純物元素の濃度が引き上げにより変化するため、所定濃度の範囲のみが製品として使用されることとなる。石英るつぼに含まれる不純物の溶け込みのため、特別に不純物を添加しない場合でも低抵抗率を呈することから比較的高抵抗率の高純度単結晶を得ることが困難である。また、石英るつぼのサイズが大きくなると融体の熱対流とさらに結晶の回転による対流が加わり、融体表面に温度差が生じることから半径方向の抵抗が縞状に変化し結晶の品質に悪影響を及ぼしやすい。 CZ単結晶の用途としては、主として、IC、LSIなどの集積素子に利用される。 (2)MCZ単結晶(抵抗率:1〜500 Ω・cm) CZ法と同様に、加熱溶融したシリコン多結晶から単結晶を引き上げる方法であるが、磁場をかけながら種結晶を引き上げる方法(MCZ法:Magnetic-Field Applied Czochralski Method)により作られる単結晶である。磁場をかけることにより融体の対流が抑制され、石英るつぼから混入する不純物の分布が均一化され高品位の単結晶を得ることができる。NTDを適用することも可能であり、この場合は、抵抗率の大きい単結晶を作り、原子炉で照射する。 MCZ単結晶の用途としては、パワートランジスタなどこれまでFZ単結晶が使われていた分野に使用されるほか、CCDや高度の集積素子に使われる。 (3)FZシリコン単結晶(抵抗率:10〜20000Ω・cm)(図2参照) シリコン多結晶の円筒棒を直立に保持し、その一部を高周波加熱により溶融し、高周波コイルを移動させることにより、ロッドの一端から順次単結晶化させる浮遊帯融液法(FZ法:Float Zoning Method)により作られ、高周波コイルの移動を繰り返すことにより純度を99.999999999%と9が11個(イレブン・ナインと呼ぶ)並ぶほどまでに高めることができる。FZシリコン単結晶の不純物添加法には、中性子照射を行うNTD法の外、単結晶の成長過程においてガス状の不純物元素を添加するガスドープ法がある。 在来製法との比較においてNTDシリコンの弱点としては、 ・原子炉を利用することに起因し、定期検査などのため長期運転停止の影響を受け、年間を通じた安定供給が難しい。 ・原子炉内の高いエネルギーをもった放射線によって生成される様々な照射欠陥を除去するため、照射後に熱処理(回復処理)を要する。原子炉の形式により熱処理の状況は異なり、一般的に高速中性子成分の少ない重水炉の方が抵抗率の回復が早い(図3)。 FZ単結晶の用途としては、主として、サイリスタ、パワートランジスタ等のディスクリート素子に利用される。FZ単結晶に比べ、CZ法をベースとするCZ単結晶とMCZ単結晶とを合わせた年間製造量は、汎用性が圧倒的に大きいことから全体の約94%を占めている。残りの6%がFZ単結晶であり、さらにその内訳としてガスドープ法によるもの4%、NTD法によるものが2%にあたる。 4.世界での状況 先に述べたように、実用規模でNTDシリコンの生産が行われるようになったのは1974年のデンマークのリソ研究所が最初である。2004年現在NTDシリコン照射を実施もしくは計画する主な研究炉は25基を超える(図4)。これらのほとんどの研究炉の出力は5MW〜30MW級である。世界でのNTDシリコンの需要は年160トン(2004年)であり(図5)、年率5〜10%程度の平均成長率で推移している。さらに最近の動きとしては、資源の有効利用化に向けた電気エネルギーへの関心の高まりを背景に、変換損失の低減化や高速動作化に対応したインバーター制御等の出力素子の需要が急速な伸びを示している。なかでも最も注目度が高いのが高速車両やハイブリッド車への利用である。また、シリコンウエハーの大口径化への流れにあって、NTDシリコンも8インチの実用照射の計画が進められている。こうした動向を捉え海外では、いちはやく8インチ大口径照射が可能な原子炉の建設や改造が進められている。既に新設炉としてオーストラリアの「OPAL」およびドイツの「FRM-II」が建設を終え、近々8インチ大口径照射を開始する予定である。中国の「CARR」が2007年臨界を目指し建設中である。また、ベルギーの「BR-2」や韓国の「HANARO」で8インチ照射設備への改造進められている。しかし、その一方で、NTDシリコンの需要が急速に8インチ照射へ移行した場合には、供給側である原子炉の設備整備が需要に追いつかず供給能力不足の状況に陥ることが懸念されている。 5.日本での状況 世界におけるNTDシリコン素材の需要量は図5に示すように年間約160トンであり、このうち内需向けを目的とする中国炉の30トンを除き、残り約130トンに対しわが国のシリコン製造メーカの占める割合は約70%(90トン程度)である。 日本においては、シリコンメーカーの依頼により、原研[現在:(独)日本原子力研究開発機構]が研究炉を利用したNTDシリコンの製造に関する照射実験を1975年に開始し、1977年から(財)放射線照射振興協会[現在:(財)放射線利用振興協会]により実用照射が開始された。 1977. 7:JRR-4、D照射筒での照射開始 1977.11:同上、L照射筒での照射開始 1983. 4:JRR-2、VT-9照射孔での照射開始 1996.10:JRR-3M、SI孔での照射開始、JRR-3の照射設備を 図6に示す。 国内炉におけるこれまでのNTDシリコンの生産量の推移を図7に示す。原子炉の稼働条件や設備容量不足のため、国内の研究炉を用いたNTDシリコンの生産量は、比較的少なく、年間約5トンと世界総生産量の約3%に留まっている。こうした状況を踏まえ国内炉の供給能力の増強を図るため、新たにJMTRの活用等について検討がはじまった。 (前回更新:1997年3月) <図/表> 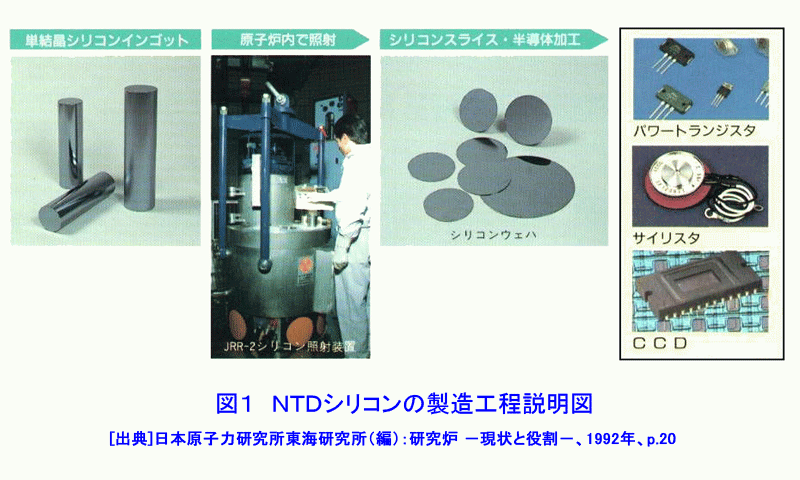
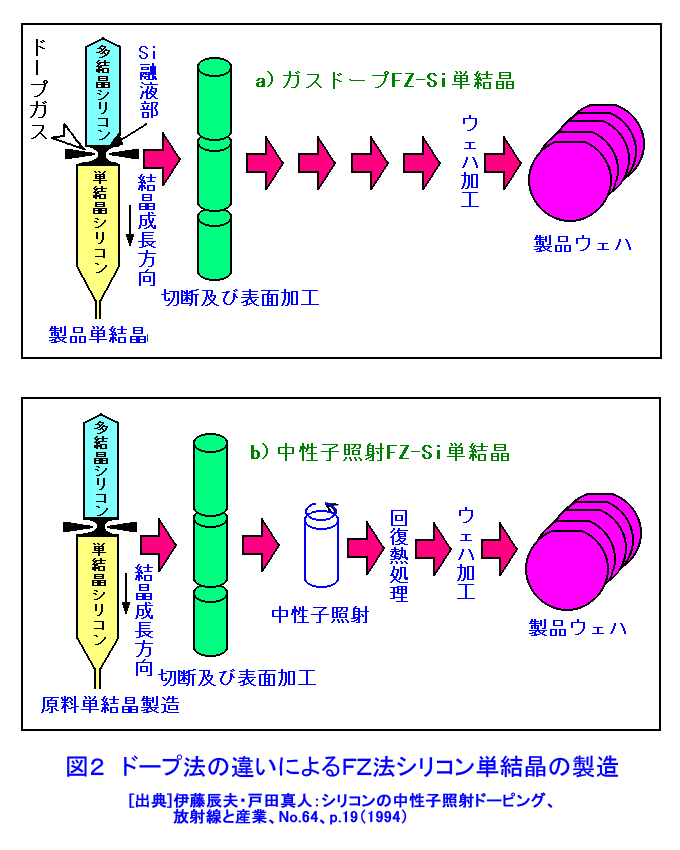
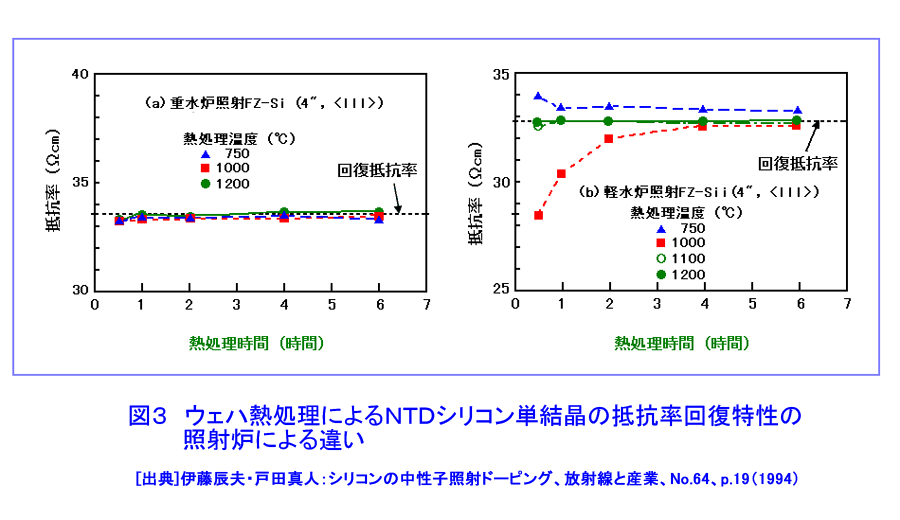




<関連タイトル> JRR-3(JRR-3M) (03-04-02-02) 放射線利用振興協会 (13-02-01-23) <参考文献> (1)M. Tanenbaum & A. D. Mills, J. Electrochem. Soc., Vol. 108 p.171(1961) (2)伊藤辰夫、戸田真人:シリコンの中性子照射ドーピング、放射線と産業、No.64.p.19(1994) (3)SEMICONDUCTOR PROCESSING, ASTM STP 850 Special Technical Publication 850 (1984) (4)日本原子力研究所研究炉部(編):研究炉利用ハンドブック 1996年、p.213?231 (5)日本原子力研究所東海研究所(編):研究炉−現状と役割−、1992年
|

