|
<解説記事ダウンロード>
<概要>
現在の半導体産業はリソグラフィと呼ばれる超微細加工技術に支えられている。リソグラフィ技術は年々進歩を遂げ2007年にはDRAM量産ラインにおいてでさえ70nmをきる加工が行われている。2013年には32nm、今から2016年には22nmの加工を2.3nmの精度で行うことが求められており、まさに、“ナノリソグラフィ”と呼ばれる領域に入ろうとしている。身の回りにある家電製品の中に入っている“マイクロチップ”が、まさに、“ナノチップ”と呼ばれる時代が始まろうとしている。過去半世紀にわたって培われたリソグラフィ技術は、半導体製造だけではなく、将来のナノテク産業を支える重要な加工技術の一つとしても大きく期待されている。これまでの微細化は露光源の高エネルギー化によって達成されており、193nmの紫外線の次は極短紫外光(13.5nm,92.5eV)が最有力候補として世界中で開発が進められている。 <更新年月> 2007年02月 (本データは原則として更新対象外とします。)
<本文>
1.リソグラフィとは 本来の意味は石版に絵・字を描く技術であり、その発明は1798年にさかのぼる。石版印刷から端を発し写真製版技術へと進展し、現在では半導体集積回路(IC)の製作技術を代表するようになった。1960年代に光リソグラフィによる半導体・電子デバイスの製作が行われて以来、リソグラフィ技術は急速な進歩を遂げ、現在に至っている。 リソグラフィ技術の進展の目安として記憶用デバイスとして用いられているDRAM(ダイナミック・ランダム・アクセス・メモリ)の製造に必要な最小線幅が一般に用いられ、2007年は65nm技術ノードと呼ばれるフェーズに相当する。インテルの創始者であるムーアが、将来のDRAMの集積度が3年で4倍になると予測して以来、予測どおりの集積度の向上が達成されている。過去半世紀にわたるこのような高集積化にはリソグラフィ技術の発展が大きく寄与している。露光源の波長(λ)と解像度(R)の関係はk1ファクターと呼ばれるプロセスファクターとレンズの開口数(NA)を使って、次式で表すことができ、 R=k1・λ/NA (1) 高解像度化を達成するために、露光源の短波長化が進められてきた。露光源は水銀灯の白色光からg線(436nm)、i線(365nm)、KrFエキシマレーザー(248nm)、ArFエキシマレーザー(193nm)と推移し、現在に至っている。この間、X線(1nm)やF2エキシマレーザー(157nm)を露光源とするリソグラフィの開発が行われたが、大量生産用リソグラフィとしての実用化には至らなかった。高解像度化は、短波長化だけでなく、(1)式中のk1ファクターと呼ばれる値を下げることによっても達成することができ、位相シフトマスク等の超解像技術を駆使することにより物理的には0.25まで下げることが可能である。さらに、液浸技術と呼ばれる最終レンズと加工対象の間に屈折率の高い媒体を挿入して解像度上げる技術を用いることにより、高解像度化が計られ、光リソグラフィの延命化が図られている。このような光リソグラフィに対して、放射線を用いたリソグラフィには電子線リソグラフィがあり、光リソグラフィよりはるかに高解像であり、10nm以下の加工例が多数報告されている。しかし、スループット(単位時間当たりに処理できるウェハの枚数)が一括照射が可能な光リソグラフィに比較して極端に低いため、大量生産には用いられず、マスクを必要とせずに直描で加工が可能である利点を生かして、光リソグラフィ用のマスク製造や、最先端デバイスの試作に用いられている。スループットの低さを解消するため電子線を用いた縮小投影露光装置や微小電子源アレイを用いた露光装置の開発が進められている。また、前述のX線リソグラフィはその透過性をいかして高いアスペクト比を必要とするMEMSやNEMSの鋳型の製造に用いられている。 2.リソグラフィの原理 図1に典型的なリソグラフィ工程を示す。まず、被加工対象を表面処理(親水処理もしくは疎水処理)し、レジストと呼ばれる微細加工用材料と基盤表面の密着性を良くした後、レジスト溶液を基板上に回転塗布(スピンコート)する。その後、ホットプレート上で基盤を加熱し、溶媒を蒸発させレジスト薄膜を形成させる(プリベーク)。レジスト薄膜を露光源からの光もしくは放射線で露光し材料に化学反応を起こさせ、現像液に対する溶解度に差を生じさせ像形成を可能にする。光以外の露光源では、EUV(極端紫外線)と電子線に対して世界規模で投資が行われているが、X線、イオンビームも有効である。近年、レジストの主流となった化学増幅型レジストでは、露光後温度をかけることによりレジストの酸触媒反応を進行させる。照射した試料を現像すると照射部に像が現れ、貧溶媒で洗浄(リンス)することにより、溶媒を洗い流す。この後、レジストを耐エッチング膜として下地加工を行ったり、イオンドープを行う。また、レジストパターンの上から金属箔膜を蒸着し、レジスト上の金属をレジストごと剥離し、基板上に金属パターンを作製することが可能である(リフトオフ法)。実際の半導体製造過程ではこの工程を数十回繰り返すことにより複雑な回路が製作される。 リソグラフィ工程で使用されるレジスト材料は、放射線によって誘起される反応に従ってポジ型とネガ型に分類される。ポジ型では放射線分解型の高分子が、ネガ型では架橋型の(高)分子が使用され、それぞれ照射部が現像液に可溶化、不溶化することによりパターンの形成が行われる。これに対して、半導体製造用の露光源が水銀灯のi線からKrFエキシマレーザーに切り替わるときに露光源のパワーの減少に対応するため高感度レジストが必要不可欠になり、化学増幅という概念がレジスト設計に導入された(実際は既存のi線製造ラインでテストが行われたので、i線で初めて使用された)。これは、露光によりレジスト中に酸を発生させ、酸による触媒連鎖反応を像形成に結びつけることにより高感度化を達成する手法である。化学増幅型レジストは極性変化型か架橋型が主流である。これは、分解型はどうしてもプラズマエッチング耐性の点で不利なためである。極性変化型は図2に示すようにヒドロキシル基のような極性基をあらかじめ非極性の置換基で保護しておき、これを酸触媒反応で脱保護することによりレジストの極性を変化させ、露光部と未露光部で現像液に対する溶解度に差を生じさせ像形成を行う手法である。したがって、用いる溶媒によりポジ型としてもネガ型としても使用することが可能である。しかし、一般的にはアルカリ水溶液が現像液として好まれるためポジ型として使用されることが多い。 3.リソグラフィの将来 近年の半導体業界では、開発費の高騰から単独では開発が不可能であるため、世界中のメーカー、サプライヤー、公的機関、大学の協力により、開発に必要な要素技術に対する要求とタイムラインに関するコンセンサスを作成し、投資の効率化を計っている。これは、ITRS(International Technology Roadmap for Semiconductors)と呼ばれており、毎年見直しが行われている。図3に今後の露光源の投入予定を示す。図中、複数の候補が挙げられているが、現行のArFエキシマレーザーの次の露光システムはArF水液浸であり導入が進んでいる。この後にEUV(極端紫外線)が来ると考えられている。EUVは現在2010年32nmノードからの投入を目指して開発が進められているが、水にかわる高屈折率液体を用いたArF液浸で32nmノードが可能であるという報告もあり、その場合はEUVは22nmノードからの登場ということになる。さらに、現状の光リソグラフィのさらなる延命化を図るため、多重露光技術が検討されている。切り替わりがどちらになるかは周辺技術を含めた今後の両技術の開発にかかっている。 4.リソグラフィの応用 かつては、中央処理装置(CPU)やメモリといえばコンピューターであったが、高度情報化社会になり、携帯電話を始め、家庭用ゲーム機、デジタルカメラ、多くの家電製品、自動車からパチンコに至るまで、リソグラフィによって作られた半導体素子が搭載されている。また、近年急速に普及が進行しているICカードの製造にもリソグラフィが用いられている。 近年ナノテクノロジーが注目を集め、量子井戸効果等のナノメーターサイズになってはじめて現れる現象の応用が研究されており、ナノテクノロジーは第二の産業革命をもたらす潜在能力があると期待されている。それに伴い、ナノスケールの加工技術として自己組織化や原子一個一個の積み上げによる加工が報告されている。しかし、ナノスケールの現象を人類が有効に利用するためには、それらを人類が知覚できるマクロスケールに結びつけることが必要不可欠であり、ナノメーターのサイズからミリメーターのサイズまで連続的に加工が可能であるリソグラフィ技術は、さらにその重要性を増すと考えられている。 (前回更新:1996年3月) <図/表> 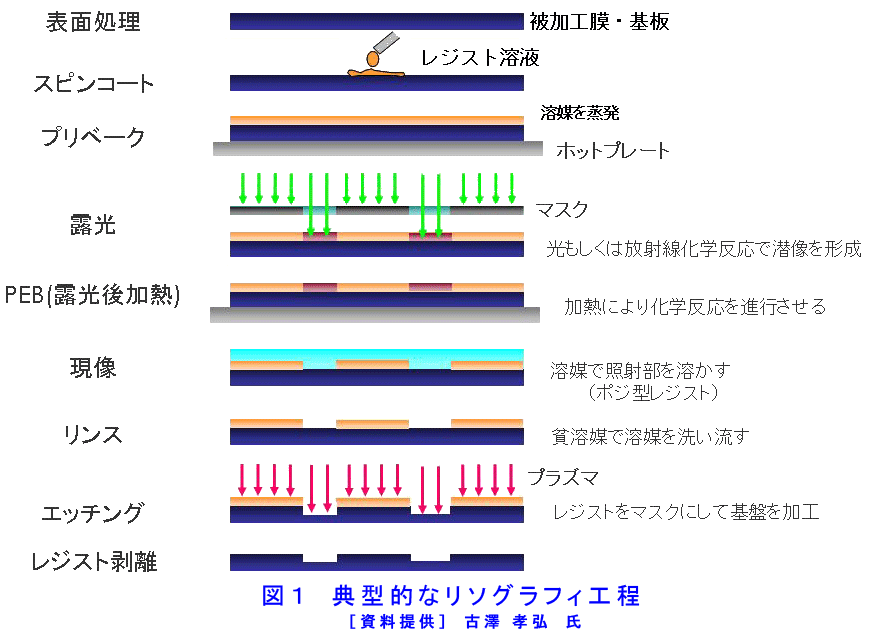

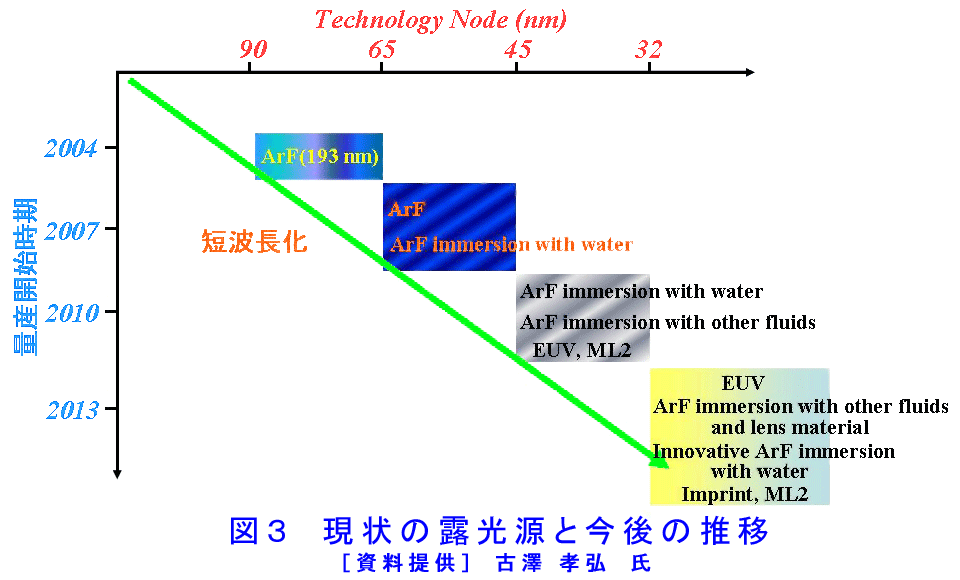
<関連タイトル> 中性子照射によるシリコン半導体製造の原理 (08-04-01-25) マイクロマシン技術の放射線計測への応用 (08-04-01-36) <参考文献> (1)岡崎信次、鈴木章義、上野巧:はじめての半導体リソグラフィ技術、工業調査会(2003) (2)麻蒔立男:トコトンやさしい超微細加工の本、日刊工業新聞社(2004) (3)応用物理学会(編)、徳山巍(編著):超微細加工技術、オーム社(1997) (4)伊藤洋:レジスト材料、共立出版(2005) (5)岡崎信次:リソグラフィー技術の将来展望、応用物理75(2006)1328 (6)International Technology Roadmap for Semiconductors:) (7)S.M.Sze:Semiconductor Devices,John Wiley & Sons,Inc.(2002)
|

